芯片化学开盖分析 (Decap)
CTI华测检测拥有完善的芯片、半导体器件失效分析工具,可为您提供完善的开封及失效分析服务,
CTI华测检测已通过CNAS/ISO17025/ISO9001资质认可,拥有完善的芯片、半导体器件失效分析工具,可为您提供完善的开封及失效分析服务,测试数据准确可靠,完备的实验室信息管理系统,保障每个服务环节的高效、保密运转。
.jpg)
什么是Decap开盖
开盖试验又称开封或者开帽,是芯片及半导体器件常用的一种失效分析检测方法。芯片或半导体器件失效分析时需分析内部的芯片、打线、组件时,因封装胶体阻挡观察,利用激光蚀刻及化学蚀刻两种搭配使用,开盖、去胶,使封装体内包覆的对象裸露出来,以便后续相关实验处理、观察。
如何进行芯片开封
芯片开封目前主要采用的方法为激光镭射(Laser)开封和化学(Chemistry)腐蚀。
▌ 激光开封
激光开封主要利用机台发射激光束于芯片塑封表面,通过气化作用去除器件填充料。此方法具有速度快、操作简便且无危险性的特点。
▌ 化学腐蚀
化学腐蚀方法主要使用某些化学试剂,如浓硫酸、盐酸、发烟硝酸、氢氟酸等。尤其是98%的浓硫酸,在此方法中用于腐蚀易溶于丙酮的低分子化合物。在超声的作用下,这些低分子化合物被清洗掉,从而暴露出芯片晶圆表层,从而达到观察分析效果。
芯片开封有什么作用
芯片开封是失效分析测试中常用的技术,主要用于检测和解决制造过程中的问题。在失效分析过程中,芯片开封是关键步骤之一,通过开封可以暴露出芯片内部结构,供失效分析人员通过肉眼或高倍率显微镜进行观察和分析。然而,开封过程中也可能引入物理损伤、外来污染等外来因素,需要进一步进行失效分析。
芯片开封的主要作用体现在以下4个方面:
▌ 失效模式分析
芯片开封后,可以对芯片内部进行详细的电性测试和物理测量,以确定芯片失效的具体模式和机制。这些测试包括测量电压、电流、功率消耗等参数,从而全面评估芯片的电性能。通过深入分析失效模式,能够了解芯片设计和制造过程中可能存在的潜在问题,并为改进提供有价值的建议。
▌ 故障定位
通过开封,可以暴露出芯片的内部结构,使得技术人员能够直接观察和分析芯片的各种元件和连接,这对于准确判断故障点非常关键。为了实现这一目的,开封过程中采用了激光镭射和化学腐蚀等方法来移除封装材料和封装层,从而精准地确定故障的位置和性质。
▌ 化学分析
芯片开封是进行化学分析的重要手段,能够确定芯片材料的组成和元素分布。这种分析对于检测潜在的材料缺陷、污染物以及由不良封装或封装材料引发的问题非常重要。通过化学分析,我们能够精确识别与材料相关的故障原因,从而采取针对性的措施来优化芯片制造过程。
▌ 封装验证
芯片开封是对封装质量进行评估的重要环节。通过仔细观察封装焊点、打线连接以及封装缺陷等细节,可以全面检查封装工艺是否符合预设的标准和要求。这一评估过程有助于确保封装的完整性和可靠性,从而防止因封装质量不良导致的芯片失效。
芯片开封在失效分析中发挥着重要的作用。它不仅涉及失效模式分析和故障定位,还包括化学分析以及封装验证等多个方面。通过芯片开封,我们能够获取关于芯片内部器件和结构的关键信息,从而准确诊断芯片故障的原因。此外,这些信息还为改进芯片制造过程、提高芯片可靠性和质量提供了有力的支持。
服务优势

服务流程

Q1:
实验多久后可以取得报告?
正常周期5~7个工作日,如需加急,请与业务联系。
Q2:
是否可以提供实验设计方案?
- 热线电话
- 业务咨询
- 快速询价
- 在线客服
- 报告验证

 在线下单
在线下单
.jpg)
.jpg)

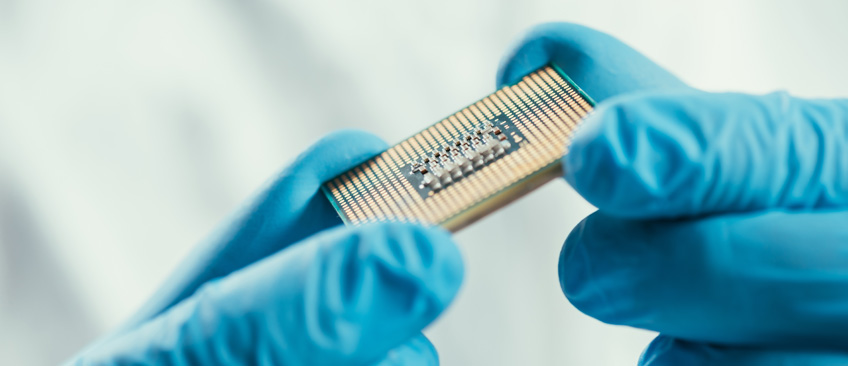
.jpg)
%20&%20EDS分析.jpg)
.jpg)
.jpg)
.jpg)

