芯片封装可靠性环境试验
提供完整的半导体产品芯片可靠性试验项目,协助客户通过JEDEC、MIL—STD、AEC-Q等可靠性国际试验标准
CTI华测检测可提供完整的芯片封装可靠性环境试验项目,包含技术整合咨询、实验设计规划、硬件设计制作、环境应力试验、封装品质试验等一站式服务,协助客户通过JEDEC、MIL—STD、AEC-Q等可靠性国际试验标准。
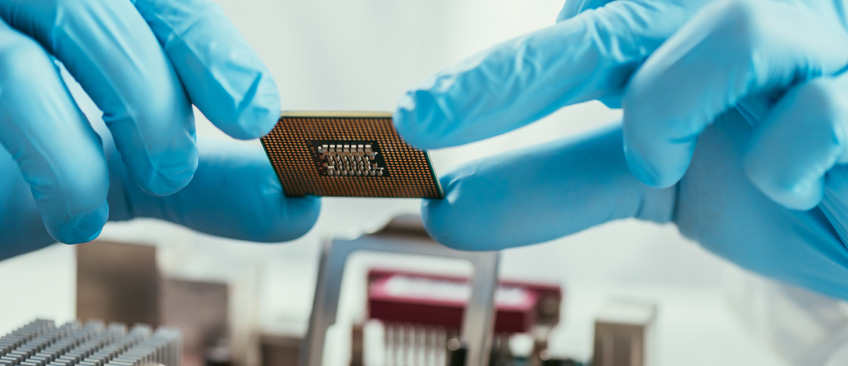
业务挑战
什么是芯片封装可靠性环境试验
芯片封装可靠性环境应力试验的目的主要是针对半导体零件的封装(Package Assembly)质量进行试验。影响封装质量的关键环境包括:封装结构的耐温水平、封装结构的抗温湿水平、封装结构的疲劳老化因素,最后是有关保存与管制的要求。
封装可靠性环境应力试验的复杂度受到环境变迁影响而更加多元,传统的单一试验逐渐的被复合式效益所取代。离如诸多空气污染衍生的酸雨、废气等,在高温下所产生的加速腐蚀模式,已非传统观念可以有效验证。
CTI华测检测可提供完整的芯片封装可靠性环境试验项目,包含技术整合咨询、实验设计规划、硬件设计制作、环境应力试验、封装品质试验等一站式服务,协助客户通过JEDEC、MIL—STD、AEC-Q等可靠性国际试验标准。
芯片封装可靠性环境试验
▌ 环境应力试验
1).湿度敏感等级区分 (Moisture Sensitive Level / MSL)
针对表面黏着型(SMD)且非密封型(Non-hermetic)零件或得经过SMT回焊制程(Reflow)之其他零件类别进行验证。判断标准主要以超音波扫描(SAT、SAM或CSAM)判断脱层(Delamination)位置与脱层比率,藉以制定湿度敏感等级。湿度敏感等级区分后,作为可靠度试验前处理 (Precondition Test)的应用。可靠度前处理的目的在于仿真零件自生产、运输至客户上线使用这个循环过程。前处理的吸湿条件是根据零件之湿度敏感等级而来,也是工厂使用时的管理参考。多项可靠度环境应力试验均需要先执行前处理后才展开。
2).温度循环试验 (Temperature Cycling Test)
温度循环测试又称为可靠度试验之母,是可靠度试验中相当重要的一项。利用温度循环加诸于零件上,产生膨胀系数不匹配的影响,长期造成零件的疲劳老化(Fatigue),发生失效的结果。以零件封装体来看,常出现的问题包括:打线脱落、结构脱层、金属断裂、焊点疲劳龟裂等现象,是最贴近真实使用的模拟。
3).温湿度偏压试验(Temperature Humidity Bias Test)
以高温潮湿的环境并加上电压,形成加速模式化学反应,产生腐蚀现象。除静态环境试验外,常使用偏压测试,更能看出封装体内部金属材料之离子迁移风险,也可同步测试产品的抗腐蚀性。由于实验时间长,可使用高加速温湿度试验 (HAST,Highly Accelerated Stress Test)替代。其差异点在加湿过程中,由于更高的温度,产生更大的大气压力,加速了腐蚀速度。根据JEDEC的定义,96小时的HAST试验可以替代1000小时的高温高湿试验(85℃ / 85% RH)。
4).高低温贮存试验(High / Low Temperature Storage Test)
此试验的目的在于验证包材料的耐温老化状态,在持续高温或者低温的状态下,使封装材料加速老化。而低温试验,在极低的温度下,利用膨胀收缩造成机械变型。对组件结构上造成脆化而引发的裂痕。高低温储存试验由于非针对封装结构,而是针对封装体材料的老化,因此实验可以不经过前处理程序。
5).耐热性试验(Thermal Resistance Test)
由于多数电子产品需要经过热的环境进行组装、拆解、维修等的程序,因此必须承受各种耐热的模拟,以确保过程不受热冲击损伤,常用的方式包括回焊(Reflow)、烙铁(Solder Iron)、热风枪(Hot Air Gun)、浸锡(Solder Dipping)等方式。
▌ 封装品质试验
1).焊锡性试验(Solderability Test)
焊锡性试验的目的在确保零件脚的电镀质量或锡球是否有污染问题。标准实验方式采取锡槽法(Solder Pot),必须达到95%以上的覆盖率。针对BGA锡球沾锡试验,目前虽无法规标准,但业界普遍采取SMT制程模拟,更贴近实际使用状态。
2).沾锡天平试验(Wetting Balance Test)
沾锡天平的实验目的在于焊锡性争议分析,透过灵敏的沾锡天平,可以确定零件脚与锡的接触反应速度,可以预知零件脚的潜在风险,补强焊锡性试验的盲点,也试过期物料验证的有效益方式。
3).推拉力试验(Pull / Shear Test)
推拉力试验主要针对封装打线制程的质量,透过此试验,并收集推拉力值进行SPC计算,确定其变异量,进行持续优化。此外,针对BGA锡球,可进行锡球推力,并参考AEC的锡球推力值,判定是否合格,以确保焊点结合强度符合标准。
4).无铅制程试验(Pb-Free Test)
无铅制程试验是一个广义的定义,电子产品导入无铅制程大约十五年,也已经相当成熟。近几年由于车用市场开始采用无铅制程,也重新开启锡须(Tin Whisker)试验需求,因此无铅制程在车用产品领域,成为标准试验项目。
服务优势

服务流程

Q1:
实验多久后可以取得报告?
正常周期5~7个工作日,如需加急,请与业务联系。
Q2:
是否可以提供实验设计方案?
- 热线电话
- 业务咨询
- 快速询价
- 在线客服
- 报告验证

 在线下单
在线下单






